
近日,中國科學院寧波材料技術與工程研究所郭煒研究員在GaN HEMT器件研究中取得新進展,相關工作以Al2O3/in-situ GaON gate dielectrics incorporated GaN MIS-HEMTs with stable VTH and significantly reduced interface state density(具有高閾值電壓穩定性和低界面態密度的Al2O3/原位GaON柵介質高電子遷移率晶體管研究)為題發表在學術期刊Applied Physics Letters中。
研究背景
基于槽柵結構的MIS-HEMT增強型高電子遷移率晶體管具有閾值電壓大、柵極驅動電路簡單等優勢,是下一代高頻功率開關器件的重點研究方向之一。但相比產業界常用的p-GaN柵HEMT,MIS-HEMT存在刻蝕界面缺陷多誘發閾值電壓(VTH)漂移與電流遲滯等問題。因此,開發與槽柵刻蝕工藝兼容的低界面缺陷態MIS柵介質是改善器件綜合性能的關鍵。
主要研究內容
中科院寧波材料所研究團隊創新性提出采用低損傷數字刻蝕工藝,在槽柵刻蝕表面原位形成GaON鈍化層,并在其上再通過ALD技術沉積Al2O3介質層,形成Al2O3/in situ GaON 疊層柵介質,實現了對凹槽柵缺陷的有效鈍化,降低了界面缺陷態密度(Dit),顯著增強了HEMT器件的溫度和電壓穩定性。
在槽柵刻蝕后,AlGaN勢壘層存在一定的等離子體損傷缺陷。因此,原位 GaON的形成過程在消除表面缺陷、鈍化懸掛鍵方面發揮了關鍵作用。圖1展示了分別采用Al2O3/in situ GaON雙層柵介質、單層Al2O3介質和單層GaON介質的MIS-HEMT器件在不同柵偏壓與不同溫度下的轉移特性。當器件在最大柵壓4至12 V范圍內進行雙掃(dual-sweep)測試時,采用雙層介質和單層GaON介質的MIS-HEMT器件的VTH僅發生了60 mV的漂移,而采用單層Al?O?介質的器件則表現出明顯的遲滯現象。在溫度升高時,HEMT器件更容易受到介電層與III-族氮化物界面處熱激活陷阱的影響。雙層Al?O?/in situ GaON器件的VTH漂移僅為約–0.28 V,遠小于單層Al?O?器件的–0.88 V。C-V測試證明,基于疊層柵介質的MIS-HEMT Dit 在4×1011-2×1012 cm-2 eV-1范圍,為領域內報道的MIS-HEMT結構的最好水平之一。綜上,結合原位GaON的低界面態密度特點和Al2O3柵介質禁帶寬度大的優勢,可以實現器件開關比和VTH穩定性的協同提升。
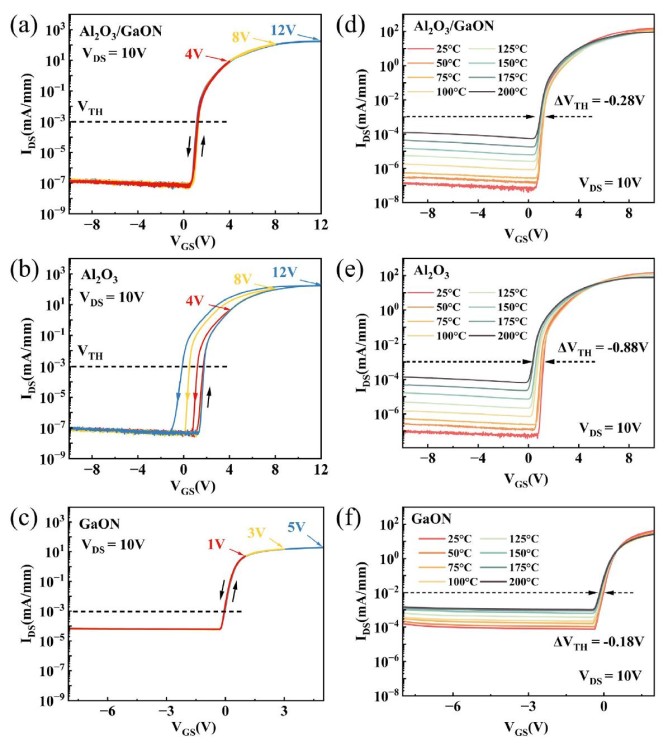
圖1,采用Al?O?/in situ GaON 雙層介質(a, d),單一Al?O?介質(b, e),單一GaON介質(c, f)的MIS-HEMT在不同柵偏壓和溫度下的轉移特性曲線
通過高分辨透射電鏡(HRTEM)與幾何相變分析(GPA),團隊發現Al2O3/GaN界面存在明顯的晶格畸變,而相比之下原位GaON插層可有效緩解該失配,形成均勻的晶格過渡區。進一步XPS分析也確認,GaON層中Ga-O鍵成分明顯增強,說明其作為“原生氧化層”在缺陷鈍化中發揮了關鍵作用。該工作對于改善MIS-HEMT器件的穩定性和可靠性、促進MIS-HEMT商業化應用提供了重要參考。
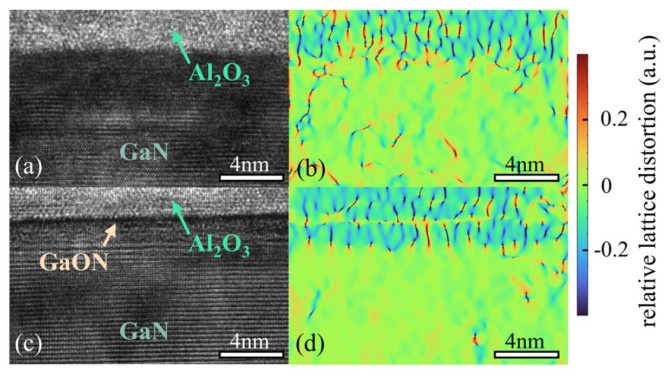
圖2 在Al?O?/GaN 和 Al?O?/in situ GaON/GaN界面處的高分辨透射電子顯微鏡及對應的晶格常數分布圖:Al?O?/GaN界面(a, b),Al?O?/in situ GaON/GaN界面(c, d)
論文第一作者為中科院寧波材料所研究生羅天,通訊作者為中科院寧波材料所郭煒研究員和葉繼春研究員。工作得到了國家自然科學基金、固態微波器件與電路國家重點實驗室以及寧波市重點研發計劃等項目的大力支持。
論文信息
Al2O3/in situ GaON gate dielectrics incorporated GaN MIS-HEMTs with stable VTH and significantly reduced interface state density
Tian Luo, Sitong Chen, Ji Li, Fang Ye, Zhehan Yu, Wei Xu, Jichun Ye*, Wei Guo*
Appl. Phys. Lett. 126, 063503 (2025)
