氮化鎵(GaN)高電子遷移率晶體管(HEMT)憑借低導(dǎo)通損耗、高開關(guān)頻率等優(yōu)勢(shì),已成為下一代功率開關(guān)應(yīng)用的有力競(jìng)爭(zhēng)者。目前肖特基型p-GaN柵HEMT已經(jīng)實(shí)現(xiàn)商業(yè)化應(yīng)用,在消費(fèi)類電子中獲得廣泛應(yīng)用。然而,目前主流的肖特基型p-GaN柵HEMT面臨高壓開關(guān)過程閾值電壓(Vth)負(fù)漂這一重大挑戰(zhàn),使器件極易發(fā)生誤開啟,嚴(yán)重阻礙了肖特基型p-GaN柵HEMT在工業(yè)/汽車等領(lǐng)域的應(yīng)用。
近日,北京大學(xué)魏進(jìn)/王茂俊/沈波團(tuán)隊(duì),在微電子器件領(lǐng)域權(quán)威學(xué)術(shù)期刊IEEE Electron Device Letters發(fā)表名為Split-p-GaN Gate HEMT With Suppressed Negative Vth Shift and Enhanced Robustness Against False Turn-On的學(xué)術(shù)論文,成功研制無閾值電壓負(fù)漂的650V/10A增強(qiáng)型GaN器件。北京大學(xué)博士研究生勞云鴻為論文第一作者,魏進(jìn)教授、王茂俊教授、沈波教授為論文共同通訊作者。
論文提出一種新型的柵極結(jié)構(gòu),Split-p-GaN柵HEMT(SPG-HEMT),圖1a為封裝器件照片,圖1b為器件柵極結(jié)構(gòu)的TEM照片。如圖1c所示,因?yàn)閜-GaN和漏極之間存在耦合電容,在高漏極偏壓下傳統(tǒng)器件的p-GaN電勢(shì)會(huì)被抬高從而導(dǎo)致Vth負(fù)漂。如圖1d所示,對(duì)于新型器件SPG-HEMT而言,靠近源極的p-GaN(p1)被靠近漏極的p-GaN(p2)屏蔽從而免受漏極高壓的影響,因此p1的電勢(shì)幾乎不受影響。在高漏極偏壓下,SPG-HEMT的Vth是由p1決定的,因此其抑制了Vth負(fù)漂。實(shí)驗(yàn)結(jié)果表明,在100V漏極電壓下,傳統(tǒng)器件的Vth會(huì)產(chǎn)生-0.33V的負(fù)漂(見圖1e),而SPG-HEMT僅出現(xiàn)-0.07V的輕微負(fù)漂(見圖1f)。
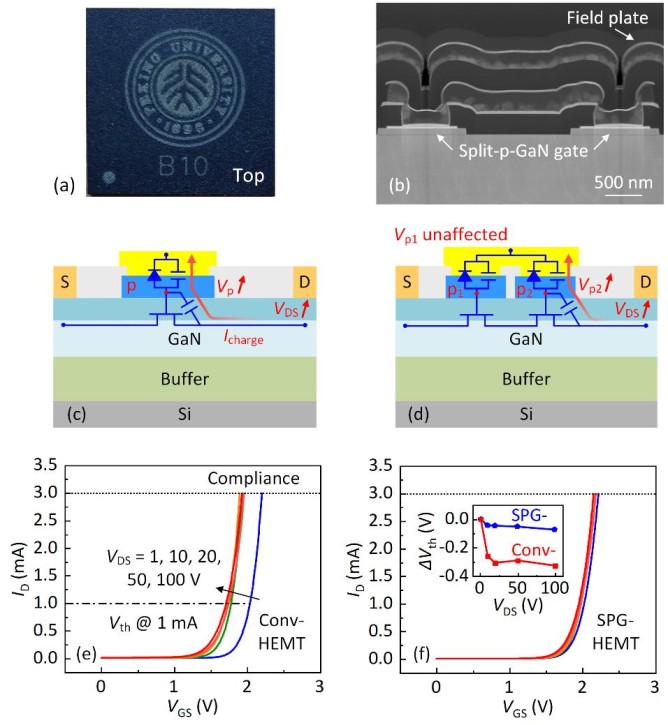
圖1 (a)封裝器件的照片。(b)新型柵極結(jié)構(gòu)的TEM圖像。(c)高漏極偏壓下傳統(tǒng)器件出現(xiàn)Vth負(fù)漂的物理機(jī)制解釋。(d)新型器件抑制Vth負(fù)漂的物理原理解釋。(e)傳統(tǒng)器件Conv-HEMT和(f)新型器件SPG-HEMT的傳輸特性曲線,插圖展示了不同漏極電壓下的Vth漂移。
團(tuán)隊(duì)搭建了半橋開關(guān)電路以評(píng)估Vth負(fù)漂對(duì)器件誤開啟魯棒性的影響(見圖2a,2b)。誤開啟易發(fā)生在器件漏極電壓快速變化的瞬間,一旦米勒效應(yīng)導(dǎo)致柵極電壓振蕩尖峰超過Vth,器件將發(fā)生誤導(dǎo)通,進(jìn)而導(dǎo)致橋臂直通故障。誤開啟測(cè)試的波形如圖2c,2d所示。由測(cè)試波形提取得到兩種器件發(fā)生誤開啟的條件。如圖2e所示,傳統(tǒng)器件在VGS-OFF ≥ -0.4 V時(shí)就發(fā)生了誤開啟,因?yàn)?i>Vth負(fù)漂加劇了誤開啟的風(fēng)險(xiǎn)。相比之下,由于新型器件SPG-HEMT能有效抑制Vth負(fù)漂,使其在VGS-OFF = 0 V時(shí)保持了關(guān)閉狀態(tài),只有當(dāng)VGS-OFF ≥ +0.6 V時(shí)才發(fā)生了誤開啟(見圖2f)。因此,在高壓開關(guān)過程中,給SPG-HEMT施加0V柵極偏壓就能避免誤開啟,無需負(fù)柵極偏壓使該技術(shù)有望簡(jiǎn)化柵極驅(qū)動(dòng)電路的設(shè)計(jì)。
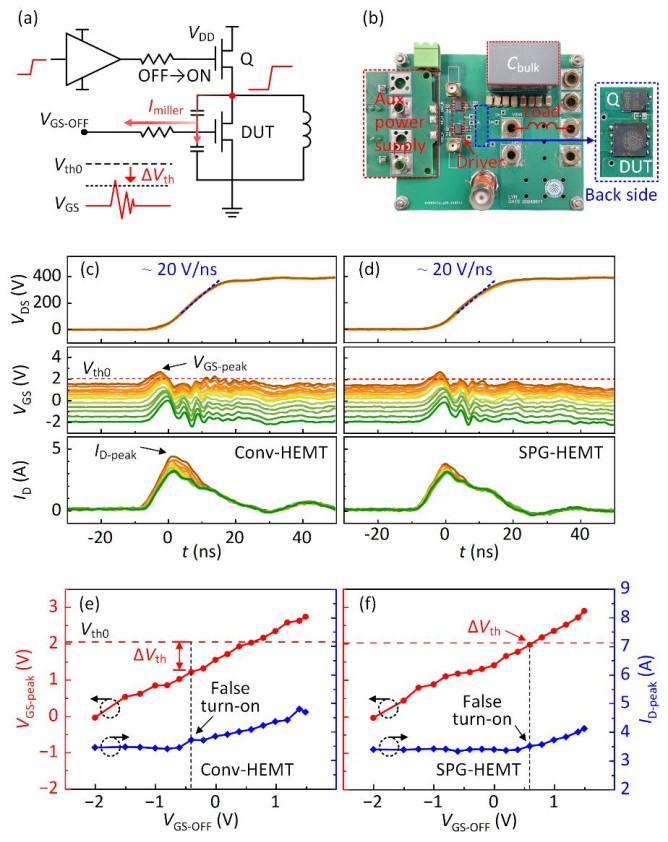
圖2 (a)半橋電路原理圖。(b)電路板照片。 (c)-(f) 傳統(tǒng)器件Conv-HEMT和新型器件SPG-HEMT的誤開啟測(cè)試結(jié)果。
綜上所述,本論文提出的新型Split-p-GaN柵HEMT器件能有效抑制漏極偏壓導(dǎo)致的Vth負(fù)漂,大幅增強(qiáng)了器件的誤開啟魯棒性。這項(xiàng)技術(shù)有希望推動(dòng)肖特基型p-GaN柵HEMT在工業(yè)/汽車等領(lǐng)域的應(yīng)用。
論文鏈接:
https://ieeexplore.ieee.org/document/10856268
